材料的最外层,即其表面,是一个极其敏感的部分,它承载着材料的化学活性、粘附性、润湿性、电学性能、光学性能、耐腐蚀性、摩擦性和生物相容性等表面特性,同时它也是一个容易因环境的降解和污染、工艺残留物的粘附等而失去这些特性的部分。
因此,表面分析不仅用于开发具有高功能性的新型表面以及利用这些表面的产品,还用于帮助高功能材料正确展现其功能。例如,在半导体制造过程中,即使表面存在极少量的污染物或异物附着,也可能导致产品不符合质量标准。此外,当发现污染时,必须首先分析污染物成分以明确原因。
表面分析方法为科学、技术和工业发展的最新进展做出了贡献。
表面分析原理
为了检测固体表面,首先必须对该表面进行激发,以检测出现的信号。光、X射线和电子被用于表面激发。在这种表面激发所产生的各种信号中,会观察到诸如仅由表面发射出的电子和离子等粒子,并对其特性进行分析,以揭示表面的化学结构。
然而,需要检测的区域不一定只限于被称为表面数原子层的极浅区域,也可能是更深的层。有时,需要几十纳米到几百纳米深度稍深区域的信息。在这种情况下,就会使用一种称为深度剖析分析的技术。通过用氩离子等刮擦表面,对暴露区域进行测量,然后重复这个过程,就可以检测稍深的区域。为了检测非常接近固体表面的数原子层,必须尽可能减少测量环境的影响。
为此,在实际进行分析时,将固体样品置于真空中进行测量。在表面分析仪内部,会产生一种称为超高真空的减压状态,其压力为大气压的十亿分之一或更低。通过控制X射线、离子和电子等带电粒子,并在这种环境下照射样品表面,可以准确检测到表面化学结构的信息。

表面分析的类型及特点
表面分析的主要类型包括X射线光电子能谱(XPS)、飞行时间二次离子质谱(TOF - SIMS)和俄歇电子能谱(AES)
XPS是一种通过照射X射线来分析光电效应产生的光电子能量的技术。它的特点是能够分析表面成分和化学键合状态。其分析区域最多限于几微米,但可用于各种材料的表面分析,无论这些材料是有机的还是无机的。
飞行时间二次离子质谱(TOF-SIMS)是一种通过照射高速离子来分析从表面发射的二次离子的技术。它的特点是具有极高的表面灵敏度,能够获取有机化合物的分子量信息,并进行高灵敏度的无机元素分析。过去,它主要用于半导体和显示材料的表面金属污染及有机材料分析,而最近则用于分析有机材料表面的有机物分布和偏析情况。
在俄歇电子能谱(AES)中,电子束照射在样品上,通过观察产生的俄歇电子对表面进行定性/定量分析。由于AES的初级激发线是电子,它可以用作电子扫描显微镜。此外,与其他表面分析方法相比,它具有极高的空间分辨率。AES的优势主要体现在对金属和半导体表面以及表面微观层面杂质的观察上。
接下来,让我们看看X射线光电子能谱(XPS)、飞行时间二次离子质谱(TOF-SIMS)和俄歇电子能谱(AES)的原理及详细特点。
一、X射线光电子能谱(XPS)
X射线光电子能谱(XPS)或化学分析电子能谱(ESCA)是一种通过向样品表面照射X射线,并测量从样品表面发射出的光电子的动能,来分析构成样品表面的元素、其组成以及化学键合状态的技术。使用Al Kα射线的XPS仪器通常可以获取样品表面几纳米范围内元素的信息。
此外,由待分析原子周围的电子态(如原子价电荷和原子间距离)引起的键能变化(化学位移)往往大于俄歇电子能谱(AES)中观察到的化学位移,这使得化学键状态相对容易识别,成为X射线光电子能谱(XPS)的另一个优势。
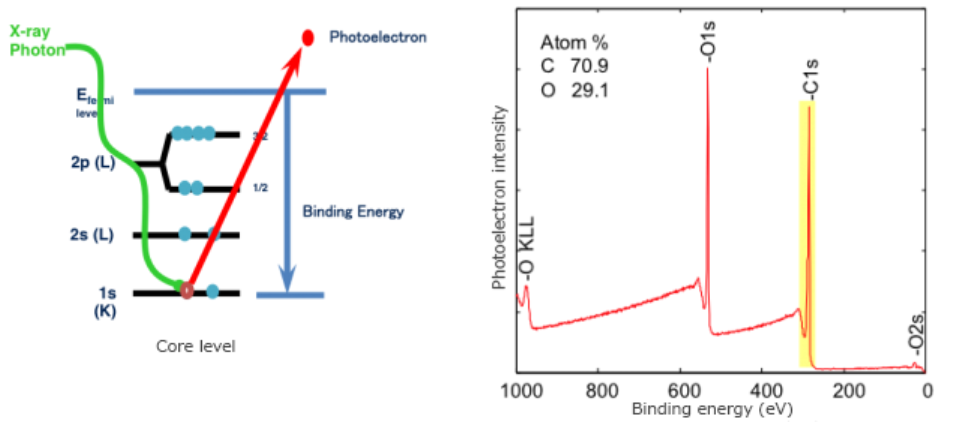
激发源
扫描微聚焦X射线源是一种能够在样品上扫描聚焦单色Al Kα束的X射线源。通常,像Al Kα射线和Mg Kα射线这样的特征X射线被广泛用作光电子的激发源。X射线束直径可设置在几µmφ到几百µmφ之间,扫描范围可以任意改变,从而能够测量适合样品的分析区域。基于这一特性的二次电子图像观察(SXI:扫描X射线图像)也可以快速准确地指定分析位置。此外,它还支持多种分析,包括多点同时分析、大面积测量、线分析和区域分析。
电荷补偿机制(双束电荷中和)
XPS用于对从导电材料到绝缘材料等各种固体样品进行元素/化学态分析。然而,对于绝缘材料样品,由于光电子的产生,X射线辐照区域会出现正电荷。与实际位置相比,在带正电状态下测量的光谱会向高结合能侧(低动能侧)移动,这使得难以掌握正确的能量位置。因此,对于绝缘材料样品,在测量过程中需要进行电荷中和。双束技术,即同时照射低能电子束和离子束,是一种以自修复方式稳定表面不均匀电荷的中和方法,能够对各种绝缘材料进行稳定的电荷中和。这也是微观区域分析的一个基本特征。
溅射离子枪(氩离子枪、团簇离子枪)
由于XPS可测量的信息深度在距表面几纳米的范围内,当表面污染层较厚或评估更深区域时,需使用离子溅射进行表面蚀刻。通过溅射与测量交替获得的光谱信息,可得到元素组成或化学键合状态的深度剖析。深度剖析用于多层结构样品的膜厚评估,以及金属变色/腐蚀的原因分析。通常,对于金属和半导体等无机材料的深度剖析分析使用氩(Ar)离子,而对于有机材料则使用富勒烯(C60)和氩气团簇离子(Ar - GCIB),因此根据材料和目的不同,会使用不同的溅射离子枪。

二、飞行时间二次离子质谱(TOF-SIMS)
飞行时间二次离子质谱(TOF-SIMS)是一种将离子束(一次离子)照射到固体样品上,并利用飞行时间差(飞行时间与质量的平方根成正比)对从表面发射的离子(二次离子)进行质量分离的技术。
飞行时间二次离子质谱(TOF-SIMS)能够以极高的检测灵敏度获取样品表面1纳米范围内有关元素或分子种类的信息。
照射到表面单位面积上的一次离子数量较少,约为10¹²离子/平方厘米或更少(硅样品表面的原子数量为10到15个原子/平方厘米),这使得分析几乎不会造成破坏。
激发源(一次离子枪)
在飞行时间二次离子质谱(TOF-SIMS)中,液态金属离子枪(LMIG)因其具有亚微米级的探针直径且能实现几百皮秒的脉冲,被广泛用作初级离子源。使用液态金属离子枪时,有3种离子源可供选择,即镓(Ga)、金(Au)和铋(Bi)。镓离子束均为单体,而金和铋离子束包含许多聚合离子。利用聚合离子可高效分析高质量分子。镓离子适用于低质量区域(主要为元素)的分析,金和铋离子则适用于高质量区域(主要为分子)的分析。
电荷补偿机制(低能电子)
飞行时间二次离子质谱(TOF-SIMS)可测量导电或绝缘材料,样品呈粉末、纤维等形式均无妨,只要能置于真空中即可。在测量绝缘材料时,会同时照射一次离子和脉冲低能电子,以防止因一次离子照射导致样品上电荷积聚。
二次离子检测系统
从固体表面发射的二次离子的能量分布范围为几电子伏特到几十电子伏特,且发射角度范围广,这导致即使质量相同,它们到达探测器的时间也会有所不同。TRIFT分析仪通过让高能离子偏离轨道,来校正因能量差异导致的飞行时间差异。此外,二次能量可以在较宽的角度范围内被捕获,即使存在几百微米的不平整度,也能获得阴影较少的图像。
溅射离子枪
由于飞行时间二次离子质谱(TOF-SIMS)的信息深度为1纳米或更小,对于较厚的表面污染层,或在评估较深区域时,需使用离子溅射进行表面蚀刻。通过在溅射和测量之间交替操作所获得的光谱信息,可以得到元素组成或分子结构的深度剖析。对于表面蚀刻,除了使用一次离子枪外,还会使用溅射离子枪。通常,对于金属和半导体等无机材料的深度剖析分析,会使用氧气(O₂)和铯(Cs)离子,而对于有机材料,则使用富勒烯(C₆₀)和氩气团簇离子(Ar-GCIB),因此,根据材料和目的的不同,会使用不同的溅射离子枪。
三、俄歇电子能谱(AES)
经辐照的电子束可聚焦至5纳米或更小,从而能够对样品的超微观区域进行分析。
激发源(场发射电子枪)
用于俄歇电子能谱的激发源与用于扫描电子显微镜(SEM)的热场发射(FE)电子源相同。场发射电子源可将样品上的电子束直径聚焦至5纳米或更小,从而实现高电流密度。
外壳
为了分析5纳米或更小的微观区域,电子束必须稳定且持续地作用于样品的某一区域。因此,用于测量微观区域的俄歇光谱仪配备了能够隔绝外界声音(声压)振动和温度变化的外壳。
检测系统(电子枪同轴CMA电子分析仪)
用作俄歇电子能量分析仪的柱面镜分析器(CMA)电子分析仪可沿其中心轴配备电子枪。将这种同轴电子枪与CMA电子分析仪配合使用,可从样品周围360度检测发射出的俄歇电子,从而能够对形状不规则且复杂的样品进行无阴影测量。
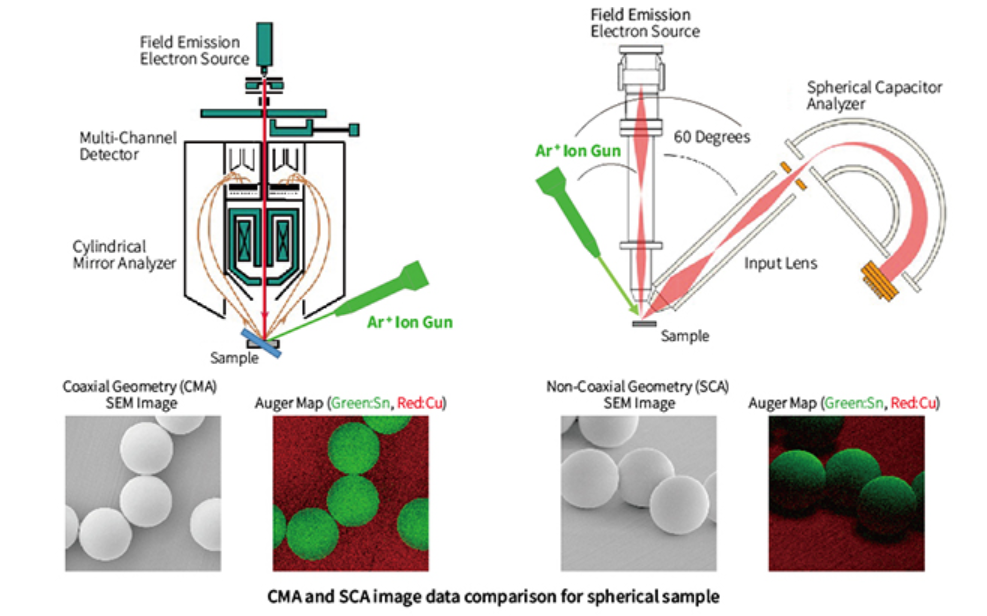
电荷补偿机制(氩离子中和)
俄歇电子能谱法在入射束中使用带负电的电子,因此在测量绝缘体时,测量位置会积累负电荷,必须对其进行中和。通过用氩离子枪发射的低速氩离子(正电荷)照射测量位置,可以消除样品上的电荷,从而能够对绝缘体进行俄歇测量。
深度剖析分析(氩离子枪)
由于俄歇电子可测量的信息深度在距表面几纳米的范围内,因此当表面污染层较厚或评估较深区域时,需使用离子溅射进行表面蚀刻。通过溅射与测量交替获得的光谱信息,可以得到元素成分深度分布。深度分布用于评估多层结构样品的膜厚,以及分析金属变色/腐蚀的原因。俄歇深度分布分析通常使用氩(Ar)离子。
 感谢点赞
+1
感谢点赞
+1





